
PCB란?
Printed Circuit Board
전자기기 내에 흔히 볼 수 있는 녹색의 회로로 별개의 전 자부품들을 배치하고 지지시키는 바탕이 되며 부품들을 전기적으로 서로 연결해주는 역할을 하는 기판이다.
전선으로 회로를 구성하지 않고 전선 대신 Board에 회로를 그려 서 전기가 통할 수 있도록 만든다.
종류로는 Rigid(경성) PCB, Flexible(연성) PCB, RF(Rigid Flexible) PCB, 다층 PCB 등이 있다.
최근 모바일 기기의 경박단소 트렌드로 인해 회로기판 또한 형태상 휘어지거나 부피가 적은 공간 에 배치됨에 따라 Flexible PCB의 사용이 많아 지고 있는 것이 트렌드다.

PCB의 종류
- 층수에 따른 분류:
- 단층 PCB (Single-sided PCB): 가장 기본적인 타입으로, 한 면에만 도전 패턴이 있는 PCB
- 양면 PCB (Double-sided PCB): 양면에 도전 패턴이 있는 PCB. 일반 가전 제품과 산업 기기에 많이 사용된다.
- 다층 PCB (Multilayer PCB): 여러 개의 층(층 / layer)로 구성되어 고밀도의 부품 실장이 가능하다. 컴퓨터, 항공기 등에 사용된다.
- 재질에 따른 분류:
- Rigid PCB: 단단한 기판으로 대부분의 PCB가 이 타입이다
- Flexible PCB (FPCB): 유연한 기판으로 휴대폰, 카메라 등 콤팩트한 기기에 사용된다
- Rigid-Flex PCB: 단단한 기판과 유연한 기판을 혼합하여 만든 PCB다
- 기판 연결 방식에 따른 분류

- 패키지 적층(Package Stack): 여러 개의 패키지를 수직으로 쌓아올린 형태다. 공간 활용도가 높아 소형화에 유리하다.
- 칩 적층(Chip Stack with Wire Bonding): 여러 개의 반도체 칩을 수직으로 적층하고 와이어 본딩으로 연결한 구조. 집적도가 높고 신호 전달 거리가 짧아 성능이 우수하다.
- 실리콘 관통 전극(Chip Stack with TSV): 반도체 칩에 관통 전극을 형성하여 수직으로 적층하는 방식이다. 와이어 본딩보다 신호 전달 속도가 빠르고 전력 효율이 높다.
와이어 본딩과 플립칩
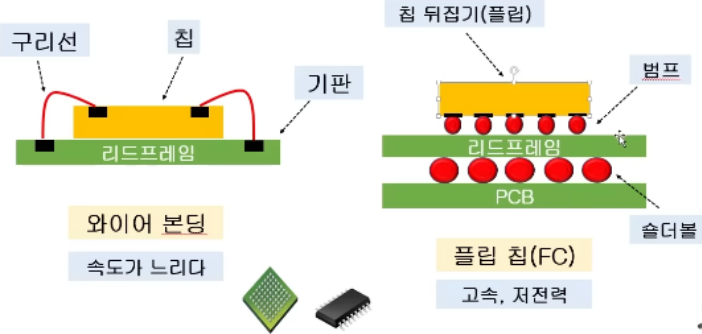
두가지 방식을 비교하면
- 전극 연결 방식:
- 와이어 본딩: 반도체 칩의 전극과 패키지 기판 사이를 금속 와이어로 연결한다.
- 플립칩: 반도체 칩의 전극과 패키지 기판의 전극을 직접 접합한다.
- 전기적 특성:
- 와이어 본딩: 와이어 길이로 인해 전기적 신호 지연이 발생할 수 있다.
- 플립칩: 직접 접합되어 신호 지연이 적고 전기적 성능이 우수하다.
- 실장 면적:
- 와이어 본딩: 와이어 루프로 인해 실장 면적이 상대적으로 크다.
- 플립칩: 칩 크기와 유사한 실장 면적을 가진다.
- 열 관리:
- 와이어 본딩: 와이어로 인한 열 전달이 제한적이다.
- 플립칩: 칩과 기판 사이의 직접 접합으로 열 전달이 우수하다.
상대적으로 플립칩 기술이 더 낫기 때문에 와이어 본딩보다 더 많이 쓰이고 있는 추세이다.

TSV

최신 방식으로 칩의 안쪽에 터널을 뚫어서 칩을 적층시키는 방식이다.
- 3D 집적화: TSV를 통해 여러 개의 반도체 칩을 수직으로 적층할 수 있어 집적도를 높일 수 있다.
- 짧은 신호 경로: 수직 배선으로 인해 전기 신호 경로가 짧아져 고속 동작이 가능하다.
- 열 관리 향상: 적층 구조에서 열 전달이 효과적이어서 열 관리가 용이하다.
- 소형화: 기존 와이어 본딩 방식에 비해 실장 면적이 작아진다.
TSV 기술은 메모리 반도체, 이미지 센서, 통신 칩 등 다양한 분야에 적용되고 있으며, 3D 반도체 패키징의 핵심 기술로 발전하고 있다. 최근에는 HBM에서 적극적으로 채택하고 있으며 얼마나 더 많이 쌓냐가 관건이 되고 있다.
기판의 종류
| 종류 | 사용처 | |
| 비메모리 | FC-BGA | CPU, 서버, 전장 |
| FC-CSP | AP(스마트폰) | |
| SiP | 통신장비 | |
| 메모리 | MCP | AP |
| BoC | 서버와 PC |
비메모리 기판
FC-BGA

- 구조: 반도체 칩을 뒤집어 기판의 BGA(Ball Grid Array) 패드에 직접 연결하는 방식
- 특징:
- 높은 I/O 수용 가능
- 짧은 배선 길이로 고속 동작 가능
- 열 관리가 용이
- 대형 패키지에 적합
개인용 컴퓨터, 서버, 자동차 전장, 스마트 티비, 콘솔기기에 적용된다.
삼성전지, LG이노텍, 대덕전자, 코리아써키트의 주력 매출원

FC-CSP
- 구조: 반도체 칩을 뒤집어 기판의 작은 CSP(Chip Scale Package) 패드에 직접 연결하는 방식
- 특징:
- 작은 실장 면적
- 높은 I/O 밀도
- 저전력 특성
- 휴대용 전자기기에 적합
삼성전기와 심텍이 주력
두 기술 모두 플립칩 방식을 사용해서 전기적 신호 경로를 최소화하고 실장 면적을 줄일수 있다.
전자는 대형 고성능 패키지에, 후자는 소형 저전력 패키지에 사용된다는 차이점이 있다.
SiP

- 집적도 향상: 여러 개의 IC 칩, 수동 소자, 배선 등을 하나의 패키지에 통합하여 집적도를 높일 수 있다.
- 소형화: SIP 패키지 크기가 작아져 전자 제품의 소형화에 기여한다.
- 성능 향상: 칩 간 배선 거리가 짧아져 고속 신호 처리가 가능하다.
- 신뢰성 향상: 내부 상호 연결이 견고해져 신뢰성이 높다.
- 제조 효율성: 패키징 공정이 단순화되어 제조 비용을 절감할 수 있다.
SIP는 스마트폰, 태블릿PC, 웨어러블 기기 등 다양한 모바일 및 IoT 제품에 널리 적용되고 있다. 메모리, 프로세서, 센서, 통신 모듈 등 여러 기능을 하나의 패키지에 통합할 수 있어 제품 개발에 유용하다.
국내 기업 중에는 심텍과 삼성전기, LG이노텍이 생산하고 있다.
HDI, FPCB, RF-PCB

- HDI (High Density Interconnect):
- 고밀도 상호 연결 기술을 적용한 PCB
- 미세한 회로 패턴과 작은 비아(Via) 홀을 사용하여 높은 배선 밀도 구현
- 소형 전자 제품, 모바일 기기, 반도체 패키징에 주로 사용
- 코리아써키트와 디에이피가 생산
- FPCB (Flexible Printed Circuit Board):
- 유연성 있는 기판 재질을 사용한 PCB
- 곡면 실장, 접힘 등이 가능하여 제품 설계의 자유도가 높음
- 디스플레이, 센서, 커넥터 등 다양한 전자 제품에 적용
- 비에이치, 인터플렉스, 뉴프렉스가 생산
- RF-PCB (Radio Frequency PCB):
- 고주파 신호 처리에 최적화된 PCB
- 낮은 손실, 균일한 임피던스 등의 특성을 갖추고 있음
- 무선 통신 장비, 레이더, 위성 통신 등의 RF 회로에 사용
- 비에이치, 인터플렉스, 뉴프렉스가 생산
MLB

멀티 레이어 보드, 다중인쇄회로 기판
HDI와 비슷한데 기판이 여러층으로 이루어진 다층 PCB를 뜻한다.
전송속도 향상으로 26층 MLB 제품 수요가 급증하였고 통신장비, 서버, 슈퍼컴퓨터, 우주항공에 적용된다.
최근에는 대덕전자가 AI향 납품을 위해 준비하고 있다.
리드 프레임

- 구조: 금속판 위에 리드(Lead)라고 불리는 금속 리드선이 부착된 구조로 되어 있다.
- 기능:
- 반도체 칩을 지지하는 기능
- 칩과 외부 회로를 전기적으로 연결하는 기능
- 외부 환경으로부터 칩을 보호하는 기능
- 재질: 구리(Cu)나 철(Fe) 등
- 제조 공정: 금속판에 리드를 부착하는 스탬핑 공정을 통해 제조된다.
국내에서는 해성디에스가 리드프레임으로 유명하다.
메모리 기판

메모리 모듈
- 구조:
- 메모리 칩(DRAM, SRAM 등)이 여러 개 실장된 인쇄회로기판
- 메모리 칩을 효율적으로 배치하고 연결하는 역할을 함
- 종류:
- DIMM (Dual Inline Memory Module)
- SIMM (Single Inline Memory Module)
- SO-DIMM (Small Outline DIMM) 등
- 기능:
- 컴퓨터 시스템의 메모리 용량 확장
- 고속 데이터 처리를 위한 메모리 기능 제공
- 표준화:
- JEDEC 표준에 따라 규격화되어 호환성이 보장됨
국내에서는 티앨비가 메모리 모듈 제품을 생산한다. 티앨비는 PC용 DDR5 메모리 모듈을 생산하며 하이닉스와 삼성전자 모두 고객사로 두고 있다.
MCP
- 구조:
- 서로 다른 기능의 반도체 칩들을 하나의 패키지에 집적
- 예: 메모리 칩과 로직 칩, 센서 칩과 프로세서 칩 등
- 장점:
- 소형화 및 경량화 가능
- 전기적 연결 거리 단축으로 고속 동작 가능
- 시스템 수준의 집적도 향상
- 응용 분야:
- 스마트폰, 태블릿 PC, 노트북 등 모바일 기기
- 자동차 전자 시스템
- 산업용 임베디드 시스템 등
MLB가 보드를 적층한다면 MCP는 칩을 적층시킨다는 차이점이 있다. 다른 기능을 가진 여러 종류의 반도체를 하나로 묶어 단일칩으로 반든 반도체를 말한다.
요즘은 HBM 시대로 빠르게 전환하면서 새로운 공정들이 부각되고 있는데 대부분 '적층'을 핵심으로 가져가고 있다. 당연하게도 어드밴스드 패키징의 중요성도 이 시기에 부각되었고 자연스레 MLB도 부각되는 것이다.
'주식 > 용어정리' 카테고리의 다른 글
| 반도체 웨이퍼란? 웨이퍼의 종류와 특징 (0) | 2024.07.16 |
|---|---|
| 플래시 메모리란? 낸드, SSD 종류 알아보기 (0) | 2024.07.15 |
| 게임업계 게임산업 용어 - CBT, OBT란? (0) | 2024.07.09 |
| 게임업계 게임산업 용어 - FGT란? (0) | 2024.07.08 |
| 정유 산업, 석유 화학 산업 용어, 업스트림과 다운스트림 (0) | 2024.07.08 |




댓글